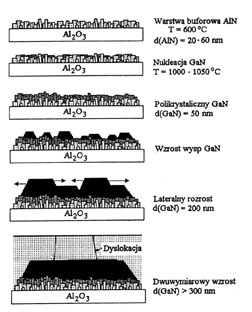
Obecnie powszechnie stosowanym podłożem w przemysłowej epitaksji azotków jest szafir. Niedopasowanie stałych sieci w tym przypadku sięga16%. Tak duża różnica stałych sieci powoduje generację dużych gęstości dyslokacji w hodowanej warstwie. Gęstości tzw. dyslokacji przenikających w heteroepitaksjalnych warstwach GaN sięgają l0i°-1011 cm-2. Mimo tak dużych gęstości dyslokacji w dziedzinie zastosowań azotków uzyskano niezwykłe sukcesy. W ostatnich pięciu latach otrzymano bardzo jasne elektroluminescencyjne diody światła niebieskiego, zielonego i białego, które obecnie są już w sprzedaży. Jednakże największym sukcesem było skonstruowanie przez Shuji'ego Nakamurę niebieskiej diody laserowej w roku 1996. Sukces ten spowodował niezwykły wzrost zainteresowania badaniami azotków na świecie. Wzrosło zainteresowanie kryształami GaN otrzymywanymi w CBW PAN metodą wysokociśnieniową. Było ono związane z możliwościami zastosowań tych kryształów jako podłoży do epitaksji. Na Uniwersytecie Warszawskim uzyskano warstwy homoepitaksjalne GaN, bardzo wysokiej jakości, charakteryzujące się rekordowo małymi szerokościami linii emisyjnych związanych z ekscytonami ą8ą. Z drugiej strony następował istotny postęp w technologii wzrostu heteroepitaksjalnych warstw GaN, zaznaczony poprawą jakości warstw, a przede wszystkim zmniejszeniem gęstości dyslokacji. Dzięki temu postępowi Nakamura skonstruował laser niebieski o pracy ciągłej. Spowodowało to gwałtowny wzrost zainteresowania laserami krótkofalowymi. Powszechnie uważa się, że będą one miały istotne zastosowania w wielu dziedzinach, w których wymagana jest duża zdolność rozdzielcza, tzn. w drukarkach laserowych, skanerach i optycznych pamięciach o dużej gęstości upakowania.
Następnym istotnym krokiem naprzód w dziedzinie poprawy własności warstw heteroepitaksjalnych (co okazało się kluczowe dla poprawy technologii laserów niebieskich) było wprowadzenie przez Nakamurę podłoży typu ELOG (Epitaxial Lateral OverGrowth). Podłoża te pozwoliły na obniżenie gęstości dyslokacji w warstwie heteroepitaksjalnej o kilka rzędów wielkości. Technika ELOG polega na częściowym maskowaniu podłoża i kolejnym wzroście następnej warstwy na tak zamaskowanym podłożu.
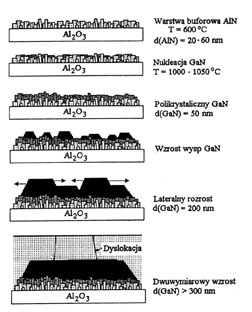
Dla warstw azotków otrzymywanych metodą ELOG pierwszym krokiem jest konwencjonalny wzrost warstwy GaN w temperaturze niemal1050°C. Ten wzrost daje warstwę GaN o gęstości dyslokacji rzędu l0i° cmą2. W następnym etapie pokrywa się metodą rozpylania całą powierzchnię GaN amorficznym 5i02 lub 5i3N4. Następnie metodą fotolitografii wytrawia się paski w odpowiednich kierunkach krystalograficznych. W ten sposób odsłania się powierzchnią GaN w postaci sukcesywnie leżących mikronowych pasków rozdzielonych obszarami pokrytymi 5i02 lub 5i3N4. Na tak przygotowanym podłożu prowadzi się kolejny wzrost warstwy w optymalnej dla wzrostu GaN temperaturze. Nukleacja GaN następuje wyłącznie na obszarach odsłoniętych. Następnie rozrastające się wyspy GaN zaczynają wychodzić na obszary zasłonięte przez 5i02 lub 5i3N4. Schematyczny rysunek opisujący formowanie się takiej warstwy poprzez jej lateralny rozrost przedstawiony jest na rys. 2. W trakcie dalszego wzrostu widoczne na rys. 2 piramidy rozrastają się na boki, zachodzą na siebie i w końcu tworzą warstwę o dobrej morfologii.
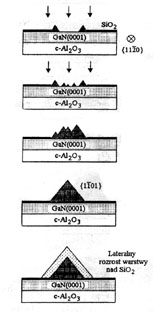
3. Mechanizm rekombinacji promienistej w diodach i laserach niebieskich
Pierwsza niebieska dioda ze złączem p-nw GaN była otrzymana w 1991 r. przez S. Nakamurę ą5ą. W diodzie tej warstwa typu p (nb =- 8 x 1018 cmą3 ) o grubości 0,8 pm była wyhodowana na grubej warstwie typu n (ne - 5x1018 cmą3) o grubości 4 ąCm. Wierzchnia warstwa była bombardowana niskoenergetycznymi elektronami w celu aktywowania akceptorów i uzyskania przewodnictwa typu p. Tak skonstruowana dioda elektroluminescencyjna miała wydajność kwantową 0,18 o i maksymalną moc promieniowania 40 ąW. W następnych latach struktura diody niebieskiej stawała się coraz bardziej wyrafinowana. Struktura obecnie otrzymywanych super jasnych diod niebieskich przedstawiona jest na rys. 3.
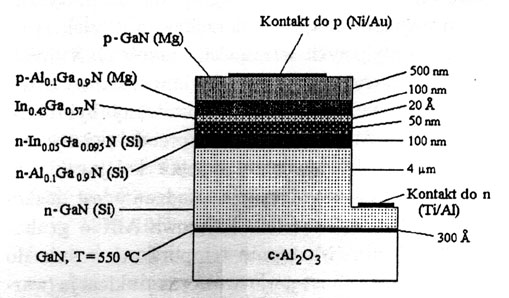
Kluczową warstwą aktywną dającą wydajne świecenie w tej diodzie jest studnia kwantowa InGaN o grubości około 2 nm, znajdująca się pomiędzy materiałem typu n a materiałem typu p Kluczową warstwą aktywną dającą wydajne świecenie w tej diodzie jest studnia kwantowa InGaN o grubości około 2 nm, znajdująca się pomiędzy materiałem typu n a materiałem typu p w złączu p-n GaN. Ta studnia kwantowa umieszczana jest pomiędzy domieszkowaną krzemem na typ n warstwą InGaN (o zawartości indu 5 0)a warstwą AlGaN (o zawartości aluminium około10% ) domieszkowaną magnezem na typ p. Warstwa InGaN domieszkowana Si jest stosowana w celu zmniejszenia naprężeń w studni kwantowej i występujących tam pól piezoelektrycznych. W tak produkowanych diodach niebieskich osiąga się obecnie moc promieniowania 6 mW i wydajność kwantową 11%. Zmieniając zawartość indu w studni kwantowej uzyskano zarówno diody zielone, jak i żółte. Nakamura otrzymał również białe diody świecące, które są obecnie wytwarzane i sprzedawane przez firmę Nichia. Są to niebieskie diody elektroluminescencyjne pokryte fosforem typu YAG, który zamienia niebieskie światło emitowane przez diodę na białe światło fosforu. Moc promieniowania białych diod elektroluminescencyjnych jest bliska 1 mW, a wydajność kwantowa sięga 3,5%. Są one interesujące dla zastosowań oświetleniowych ze względu na to, że mają znacznie dłuższy czas życia i wyższą wydajność konwersji energii elektrycznej na światło niż konwencjonalne żarówki.
Wysokie wydajności diod świecących dowodziły, że dyslokacje przechodzące przez obszar aktywny InGaN nie zachowują się jak centra rekombinacji bezpromienistej. Dodatkowym argumentem za tym był fakt, że wydajności takich diod świecących otrzymywanych zarówno na szafirze, jak i na podłożach ELOG, różniących się gęstościami dyslokacji o kilka rzędów wielkości, były identyczne. Z drugiej strony są dane doświadczalne świadczące, że dyslokacje przenikające tworzą centra rekombinacji bezpromienistej w GaN (12,13ą. Uważa się, że emisja światła z obszaru aktywnego pochodzi z fluktuacji indu występującego w studni kwantowej InGaN. Fluktuacje składu indu w studni prowadzą do wytworzenia się w niej dysków kwantowych, przypominających samoorganizujące się kropki kwantowe. Te dyski kwantowe tworzą stany zlokalizowane, w których zarówno elektrony, jak i dziury są pułapkowane, zanim dosięgną centrów rekombinacji bezpromienistej tworzonych przez dyslokacje. W związku z tym droga dyfuzji nośników mniejszościowych musi zależeć głównie od fluktuacji potencjału w studni InGaN, a nie od dyslokacji. Wynika stąd wniosek, że w diodach o wysokiej wydajności odległości pomiędzy fluktuacjami indu muszą być mniejsze niż średnie odległości między dyslokacjami. Średnie wymiary indowych dysków kwantowych ocenia się na około 10 nm, a ich szacowana gęstość może być większa niż gęstość dyslokacji występujących w warstwach GaN. Tak więc, w prostych diodach elektroluminescencyjnych podłoża typu ELOG nie mają zdecydowanej przewagi nad podłożami szafirowymi, gdyż wydajność świecenia diody zależy od formowania się gęstej sieci dysków kwantowych w obszarze studni kwantowej InGaN. Jednakże gęstości dyslokacji mają wpływ na prąd diody w kierunku zaporowym, który dla warstw hodowanych na podłożach szafirowych wzrasta o dwa rzędy wielkości.
Ten niezwykle udany rozwój technologii diod elektroluminescencyjnych i zrozumienie mechanizmów ich pracy położyły podstawy dla wzrostu struktur odpowiednich dla niebieskich laserów.
W strukturach laserowych oprócz zlokalizowanych stanów rekombinacyjnych w studniach kwantowych InGaN wymagane jest samo ogniskowanie światła. W tym celu należy warstwy InGaN umieścić pomiędzy stosunkowo grubymi warstwami AlGaN. Wówczas układ warstw zapewnia takie gradienty współczynników załamania, że światło jest utrzymywane w obszarze aktywnym InGaN. Hodowanie gładkich warstw AlGaN jest jednak w istotny sposób utrudnione. Naprężenia występujące w nich powodują, że w trakcie stygnięcia warstwy te pękają. Pękaniu warstw oraz zmniejszeniu się gęstości dyslokacji można zapobiec przez hodowanie supersieci AlGaN/GaN. Tego typu supersieci spełniają warunek ogniskowania światła oraz są mechanicznie wytrzymałe na występujące naprężenia. Struktura lasera wymaga również stworzenia wnęki optycznej. Wnęka taka formowana jest wzdłuż kierunku pasków 5i02, a na jej końcu napylane są lustra z warstw dielektryków Ti02 /5i02 .
Warstwę aktywną w laserze niebieskim stanowi para studni kwantowych InGaN (o zawartości indu około 15% ) o grubościach 3,3-4 nm rozdzielonych 10 nm barierami domieszkowanych krzemem warstw InGaN (o zawartości indu około2 0). W celu obniżenia prądu progowego, przy którym zachodzi akcja laserowa, struktury laserowe wykonywano na podłożach ELOG. Jest to kluczowy element konstrukcji lasera - niskie gęstości dyslokacji zapewniają niskie natężenie prądu progowego. Przy większych ich gęstościach następuje przepływ prądu w obszarze dyslokacji, co prowadzi do konieczności zwiększenia gęstości prądu, a przez to do szybszej degradacji lasera. Tak więc obniżenie gęstości dyslokacji jest konieczne z punktu widzenia wydłużenia czasu życia lasera. Uzyskane dotychczas przez Nakamurę gęstości prądów krytycznych w laserach niebieskich otrzymywanych w części niskodyslokacyjnej podłoży ELOG wynoszą około 3 kA/cm2, a mocpromieniowania sięga 10 mW. Z drugiej strony gęstości prądów krytycznych w laserach otrzymywanych w części wysokodyslokacyjnej podłożu wynosiły 9 kA/cm2 (14ą. Te różnice w gęstoprogowego. Przy większych ich gęstościach następuje przepływ prądu w obszarze dyslokacji, co prowadzi do konieczności zwiększenia gęstości prądu, a przez to do szybszej degradacji lasera. Tak więc obniżenie gęstości dyslokacji jest konieczne z punktu widzenia wydłużenia czasu życia lasera. Uzyskane dotychczas przez Nakamuręgęstości prądów krytycznych w laserach niebieskich otrzymywanych w części niskodyslokacyjnejpodłoży ELOG wynoszą około 3 kA/cm2, a mocpromieniowania sięga 10 mW. Z drugiej stronygęstości prądów krytycznych w laserach otrzymywanych w części wysokodyslokacyjnej podłoiywynosiły 9 kA/cm2 (14ą.
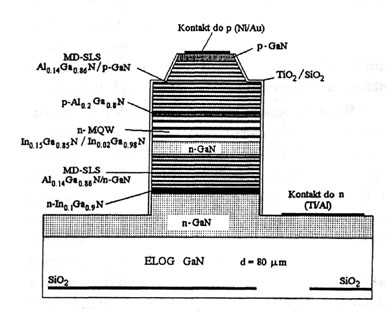
Te różnice w gęstościach prądów odbijają się w czasach życia obut ypów laserów. Rekordowo długie czasy życia laserów uzyskane na częściach niskodyslokacyjnych podłoży ELOG sięgają 10 tys. godzin. Biorąc pod uwagę czas życia, jak i moc promieniowania, należy stwierdzić, że lasery niebieskie otrzymane przez Nakamurę osiągnęły już próg, po którym może nastąpić ich wprowadzenie do produkcji przemysłowej. Technologia struktur laserowych azotków jest jednak niezwykle trudna. Jak dotychczas tylko Nakamura osiągnął pułap długożyciowego niebieskiego lasera pracy ciągłej. Kilkanaście zespołów z USA i Japonii uzyskało akcję laserową w reżimie impulsowym lub w krótkich okresach czasu. W Europie jak dotąd żaden zespół nie doprowadził swoich prac badawczych do struktury, w której może nastąpić jakakolwiek akcja laserowa. ściach prądów odbijają się w czasach życia obu typów laserów. Rekordowo długie czasy życia laserów uzyskane na częściach niskodyslokacyjnych podłoży ELOG sięgają 10 tys. godzin. Biorąc pod uwagę czas życia, jak i moc promieniowania, należy stwierdzić, że lasery niebieskie otrzymane przez Nakamurę osiągnęły już próg, po którym może nastąpić ich wprowadzenie do produkcji przemysłowej. Technologia struktur laserowych azotków jest jednak niezwykle trudna. Jak dotychczas tylko Nakamura osiągnął pułap długożyciowego niebieskiego lasera pracy ciągłej. Kilkanaście zespołów z USA i Japonii uzyskało akcję laserową w reżimie impulsowym lub w krótkich okresach czasu. W Europie jak dotąd żaden zespół nie doprowadził swoich prac badawczych do struktury, w której może nastąpić jakakolwiek akcja laserowa. Można zadać pytanie, czy zastosowanie podłoży z monokrystalicznego GaN może dokonać dalszego istotnego postępu w dziedzinie rozwoju technologii GaN. Mimo dużych nadziei z tym wiązanych, w szczególności w laserach dużej mocy, trudno na to pytanie dać definitywną odpowiedź. Rozwój technologii azotków był od początku pełen niespodzianek i zaskakujących rozwiązań. Tylko doświadczalne zastosowanie monokrystalicznych podłoży GaN do struktur laserowych może rozstrzygnąć tę kwestię. Niestety, takie doświadczalne rozstrzygnięcie może być obecnie dokonane tylko przez Nakamurę, w którego rękach technologia wytwarzania struktur laserowych azotków ma stale nieosiągalny dla innych poziom.